ME 290R Lecture 2.2: Lithography Performance Criteria - Technical (Yield Modeling)
ME 290R Lecture 2.2: Lithography Performance Criteria - Technical (Yield Modeling)
-
 1. Lecture 2.2 Lithography Perfor…
0
00:00/00:00
1. Lecture 2.2 Lithography Perfor…
0
00:00/00:00 -
 2. What factors need to be borne …
48.915582248915584
00:00/00:00
2. What factors need to be borne …
48.915582248915584
00:00/00:00 -
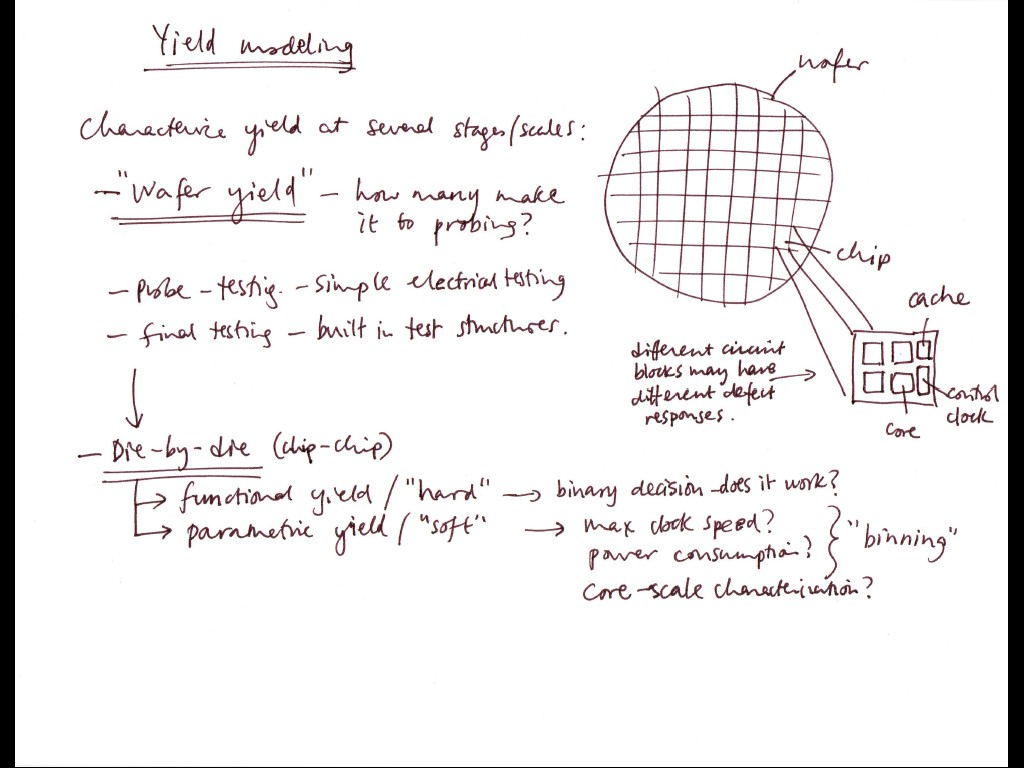 3. Yield Modeling
55.155155155155157
00:00/00:00
3. Yield Modeling
55.155155155155157
00:00/00:00 -
 4. Critical area
687.2205538872206
00:00/00:00
4. Critical area
687.2205538872206
00:00/00:00 -
 5. Yield modeling continued
1205.6723390056725
00:00/00:00
5. Yield modeling continued
1205.6723390056725
00:00/00:00 -
 6. How can we characterize manufa…
1614.2809476142811
00:00/00:00
6. How can we characterize manufa…
1614.2809476142811
00:00/00:00 -
 7. Scanning electron microscopy: …
1674.7080413747081
00:00/00:00
7. Scanning electron microscopy: …
1674.7080413747081
00:00/00:00 -
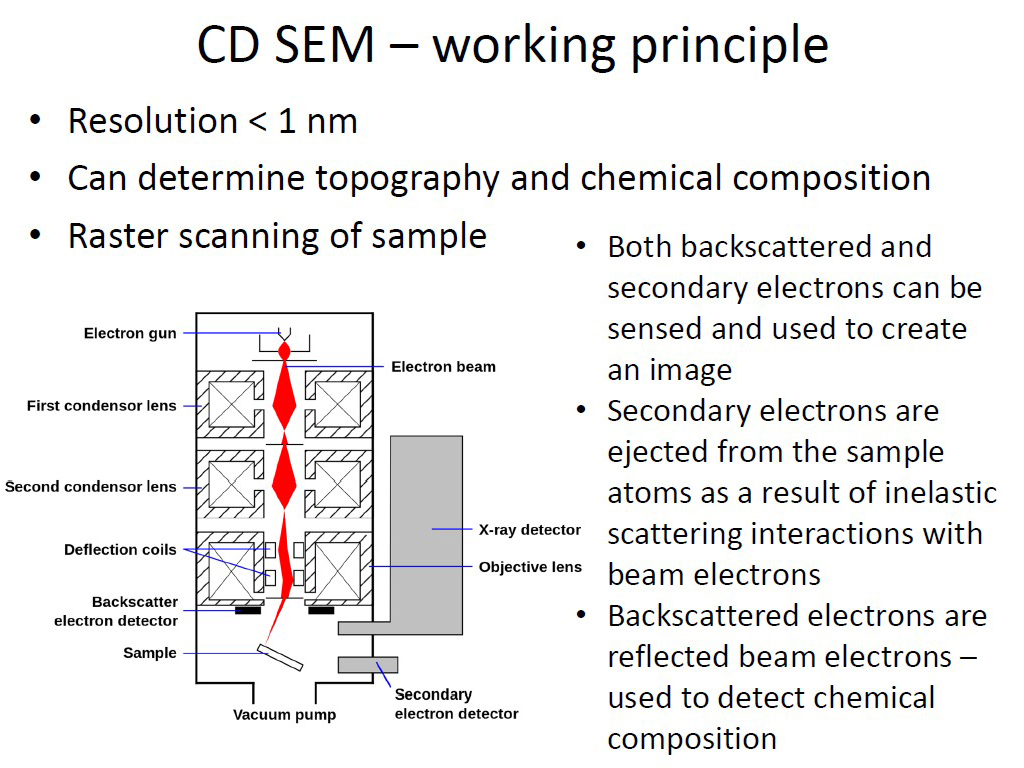 8. CD SEM - working principloe
1743.4100767434102
00:00/00:00
8. CD SEM - working principloe
1743.4100767434102
00:00/00:00 -
 9. Atomic force microscopy
1752.218885552219
00:00/00:00
9. Atomic force microscopy
1752.218885552219
00:00/00:00 -
 10. Scatterometry
1951.3513513513515
00:00/00:00
10. Scatterometry
1951.3513513513515
00:00/00:00 -
 11. Electrical/functional test str…
2223.1564898231568
00:00/00:00
11. Electrical/functional test str…
2223.1564898231568
00:00/00:00